
[研究概要]
国立大学法人東海国立大学機構 名古屋大学未来材料・システム研究所 須田 淳 教授、天野 浩 教授と旭化成株式会社らの研究グループは、次世代半導体材料として期待される窒化アルミニウム(AlN)系材料において、理想的な特性を示すpn接合(注1)を作製することに世界で初めて成功しました。pn接合は半導体電子素子(電子デバイス)の根幹をなす基本構造であり、本成果は、AlN系電子デバイスの今後の発展の礎となるものです。
現在広く使われている半導体材料であるシリコン(Si)やガリウムヒ素(GaAs)の4~5倍の禁制帯幅(バンドギャップ)(注2)を有するウルトラワイドバンドギャップ(UWBG)半導体(注3)は、高周波デバイス(注4)、パワーデバイス(注5)の格段の性能向上を実現可能な次世代半導体材料として注目され、世界的に研究が活発化しています。しかしながら、UWBG半導体においては、半導体デバイスの根幹となる理想的なpn接合の実現が困難という課題がありました。本研究グループは、UWBG半導体の一つであるAlN系材料において、高品質AlN単結晶基板上に分布型分極ドーピング(distributed polarization doping)(注6)という手法でpn接合を形成することで、電流-電圧特性、電圧-容量特性、電流注入による発光特性において非常に良好な特性を示す、理想的なAlN系pn接合の実現に世界で初めて成功しました。旭化成の子会社であるクリスタル・アイエス(CIS)が開発した高品質AlN単結晶基板、名古屋大学と旭化成で共同開発したAlN系薄膜結晶成長技術(エピタキシャル成長技術)、名古屋大学エネルギー変換実験施設(C-TEFs)の次世代半導体クリーンルームを活用したデバイス形成技術により実現が可能となったものです。
本研究成果は、本学博士後期課程学生の隈部 岳瑠さんにより2023年12月12日15:10-15:35(アメリカ太平洋時間)に世界トップクラスの半導体デバイスに関する国際会議(International Electron Device Meeting, IEDM(注7), 米国サンフランシスコ開催)で発表されました。
[研究のポイント]
- 次世代半導体材料として期待される窒化アルミニウム(AlN)系材料において、理想的な特性を示すpn接合を作製することに世界で初めて成功した。
- AlN系半導体は次世代の高周波デバイス、パワーデバイス材料として期待を集めている。pn接合は半導体デバイスの根幹をなす基本構造であり、本成果は、AlN系デバイスの今後の発展の礎となる。
- CISが開発した高品質AlN単結晶基板、名古屋大学と旭化成で共同開発したAlN系薄膜結晶成長技術(エピタキシャル成長技術)、名古屋大学未来材料・システム研究所エネルギー変換実験施設(C-TEFs)の次世代半導体クリーンルームの活用により本成果を達成した。産学連携、本学の次世代半導体研究拠点の活用による成果である。
[研究背景と内容]
研究背景
- 次世代パワーデバイス、高周波デバイス用材料として注目を集めるAlN系ウルトラワイドバンドギャップ(UWBG)半導体材料が注目を集めている。次世代半導体材料として期待される窒化アルミニウム(AlN)系材料において、理想的な特性を示すpn接合を作製することに世界で初めて成功した。
- UWBG半導体の研究が発展すると、パワーデバイスの損失低減によるさらなる省エネの実現、高周波デバイスの高周波化による通信速度向上などに貢献できる。
- しかしながら、UWBG半導体に共通する技術的課題として、電子デバイスの根幹となるpn接合の作製が困難という問題があった(従来半導体であるSiやGaAsではpn接合の形成は容易であり、それが早期の実用化につながった)。
| 材料 | バンドギャップ |
| シリコン(Si) | 1.1 eV |
| ガリウムヒ素(GaAs) | 1.4 eV |
| 炭化ケイ素(SiC) | 3.3 eV |
| 窒化ガリウム(GaN) | 3.4 eV |
| ダイヤモンド(C) | 5.5 eV |
| 酸化ガリウム(Ga2O3) | 4.8 eV |
| 窒化アルミニウム(AlN) | 6.0 eV |
本研究のポイント
- 従来の不純物ドーピング(注8)ではなく、化学組成(AlNに対して数%~30%のGaNを混合する)を空間的に変化させる分布型分極ドーピング(distributed polarization doping, DPD)と呼ばれる手法を使用することで、特性の優れたAlN系p層、n層の実現を目指した。
- 理想通りのDPDを発現させるためには高品質な薄膜結晶成長技術が必要で、その研究開発も精力的に進めた。
- 作製したAlN系pn接合は、理想的な電流-電圧特性、電圧-容量特性、電流注入による発光特性を示した。特に電流-電圧特性において、優れた高電圧に対する耐性を示した。
- このような優れた特性を全て満たすAlN系pn接合の実現は世界初。
- 高耐圧特性について、絶縁破壊電界強度を求めると7.3 MV/cmとなり、これは従来半導体のSiの25倍、絶縁破壊電界強度に優れたワイドバンドギャップ(WBG)半導体であるSiCやGaNに対しても2倍の値である。
本研究で作製したデバイスの断面構造
高品質AlN(0001)基板上に有機金属気相エピタキシャル成長(MOVPE)法を用いて、ドーピングを行わないAlN層、高濃度n型Al0.7Ga0.3N層を形成したのち、AlNのモル分率を徐々に増加させた層(n型DPD層)、AlNのモル分率を減少させた層(p型DPD層)を形成。最後に高濃度p型GaN層を形成した。最上部の高濃度p型GaN層と、下部の高濃度n型Al0.7Ga0.3N層に電極を形成し、pn接合ダイオードを作製した。
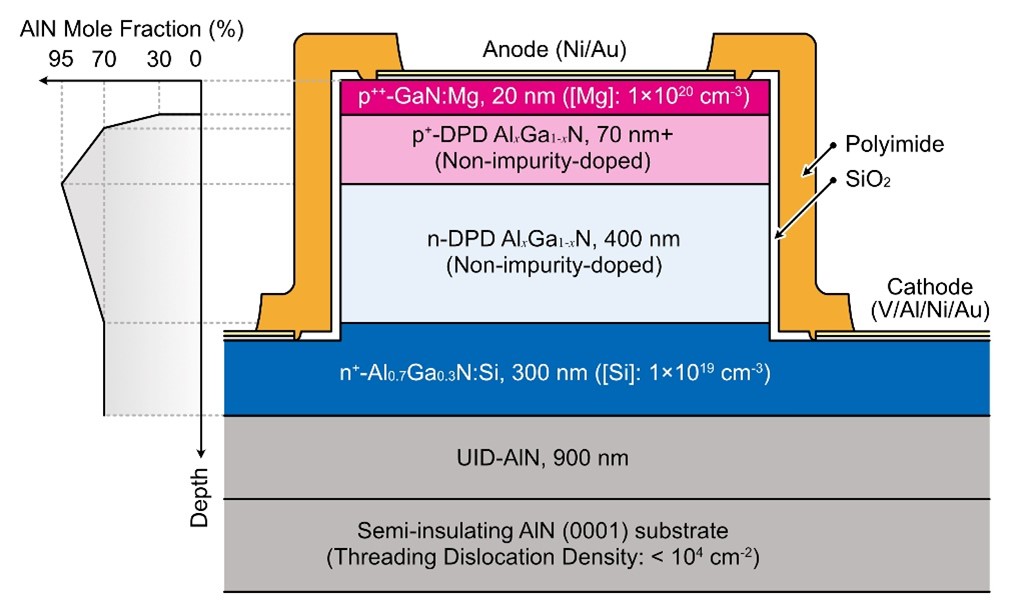
作製したAlN系pn接合ダイオードの電気測定の様子
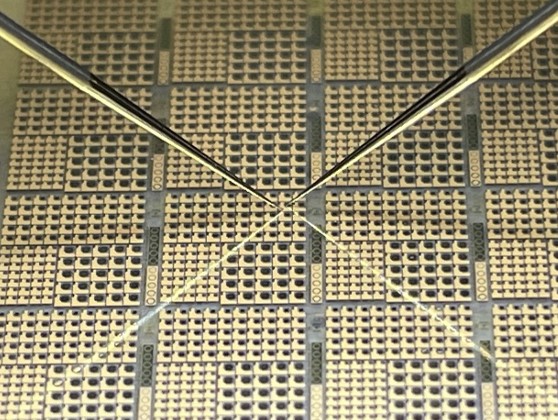
AlNウエハ上に作製したpnダイオードに2本のプローブを当てて測定を行っている様子。一つ一つの模様が一つのダイオード。
絶縁破壊電界のベンチマーク
WBG半導体であるSiCやGaNに比べて2倍の7.3 MV/cmの絶縁破壊電界強度が得られた。これはAlN系pn接合の絶縁破壊電界強度実測値として世界最高記録である。本研究では耐圧向上の工夫を行っていないため、今後の研究でこの値はさらに向上することが期待される。
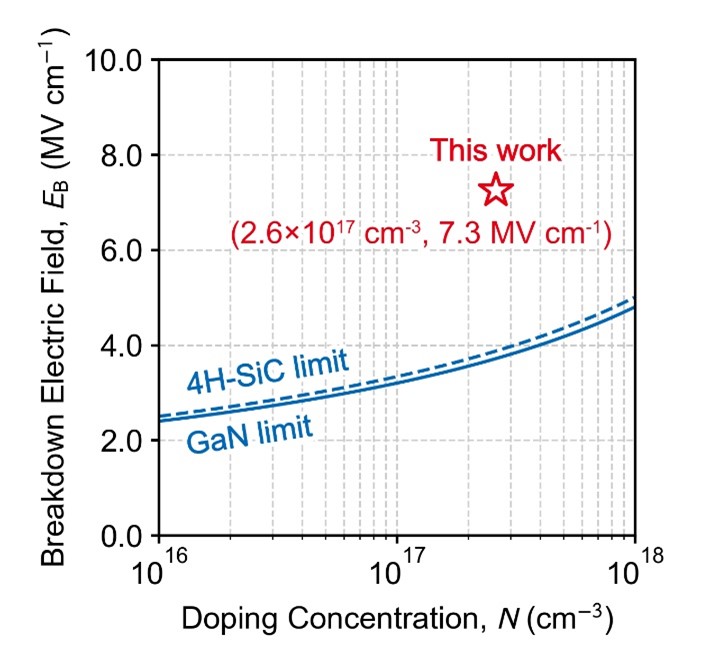
なぜ世界に先駆けて実現できたのか?
- ①高品質なAlN単結晶基板(下地材料)の利用、②理想的なDPD層の形成を実現するための工夫を凝らした薄膜結晶成長技術(エピタキシャル成長技術)、③デバイス(pn接合ダイオード)作製技術が一体となることで実現できた。(①は旭化成の技術、②と③は名古屋大学と旭化成の共同研究)
- 名古屋大学と旭化成は長年にわたりAlN系半導体を用いた深紫外領域レーザーダイオードの研究開発を行っており、AlN系材料の薄膜結晶成長、デバイス作製技術に関する豊富な経験と技術的な蓄積があった。
- 名古屋大学はGaN系材料のDPDによるpn接合において成果を上げており、DPDの設計などについて技術的な蓄積があった。
- デバイス作製については、次世代材料のための半導体クリーンルーム施設である、未来材料・システム研究所 エネルギー変換エレクトロニクス実験施設(C-TEFs) を活用した。
写真:高品質AlN単結晶基板(旭化成提供)
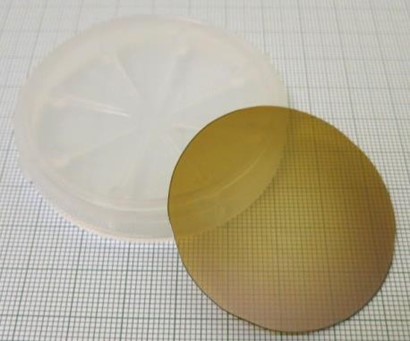
2インチAlN単結晶基板(AlNウェハー)
写真:エネルギー変換エレクトロニクス実験施設(C-TEFs)
GaNをはじめとした次世代半導体材料の研究開発拠点として最先端クリーンルームを整備。結晶成長やデバイス作製などを行うことができる。
[成果の意義]
WBG半導体の社会実装はGaN系半導体の光デバイスからはじまり、続いてSiCパワーデバイスの鉄道車両への搭載、GaN系高周波デバイスの携帯電話基地局への搭載、そして、近年ではGaNパワーデバイスのUSB充電器への搭載などと広がり、安全・安心な暮らし、あるいは低炭素社会実現に貢献しています。半導体分野の最先端研究では、より優れた性能・特性の実現を目指して、UWBG半導体の研究が活発化しています。しかしながら、WBG半導体と比べるとさまざまな技術的課題が存在し、従来半導体の手法や理論に基づくアプローチでの解決は困難であり、さまざまな工夫が試みられています。本研究では不純物ドーピングの代替として分布型分極ドーピングを活用することにより、AlN系半導体でも良好なpn接合を実現できることを実験的に示し、また、AlN材料の最も重要な物性値である絶縁破壊電界強度について、実験的に従来のWBG半導体の少なくとも2倍であることを証明しました。本研究成果が契機となり、AlN系材料の研究が活発化し、また、DPDを活用したさまざまなデバイスの研究開発も広がると期待されます。
窒化物半導体GaN青色LEDは名古屋大学において赤﨑教授、天野教授が大きなブレイクスルーを成し遂げて実用化の道が開かれました。名古屋大学は窒化物半導体の世界的研究拠点を構築し、さまざまな企業、大学、海外との共同研究を進めています。本成果に限らず、窒化物半導体のさまざまな展開を考え、基礎研究、応用研究を展開してまいります。
旭化成のコア技術であるAlN系材料は旭化成製品でもあるUV-C LED、名古屋大学との共同研究成果におけるUV-C レーザーダイオード、など光デバイスが先行していましたが、本研究でも示されたようにパワーデバイスとしても非常に期待できる素材です。旭化成は速やかな社会実装を目指して研究開発により一層の力を入れていきます。
[用語説明]
(注1)pn接合:
半導体デバイス(素子)の基本構造の一つ。電子が多数存在するn型半導体と正孔が多数存在するp型半導体を積層した構造。電流を一方向にのみ流す整流作用、電流注入による発光、光照射による起電力などの特性を持つ。(↑ 本文に戻る)
(注2)禁制帯幅(バンドギャップ):
半導体材料の最も重要な物性(特性)値の一つ。半導体中に電子と正孔のペアを形成するために必要なエネルギー。単位は電子ボルト(eV)が使われる。最も広く用いられているSi半導体のバンドギャップは1.1 eV。(↑ 本文に戻る)
(注3)ウルトラワイドバンドギャップ(UWBG)半導体※:
バンドギャップがおおむね5 eV以上の半導体。さらに将来を見据えて、SiCやGaNよりさらにバンドギャップの大きな半導体の研究開発も活発化している。代表的な半導体は、ダイヤモンド(5.5 eV)、Ga2O3 (4.8 eV)、AlN (6.0 eV)が挙げられる。原理的にはWBG半導体よりも格段の性能向上が期待できるが、技術的に解決しなければならない課題がいくつかある。特に電子デバイス作製の根幹となるpn接合の実現が非常に難しいことが材料に関わらずUWBG半導体の共通の課題になっている。pn接合を使用しないデバイスの研究もおこなわれているが、pn接合が利用できると、デバイス設計の自由度や利用可能範囲が大きく広がり、また、UWBG半導体の優れた特性を完全に引き出すことが可能となる。
※ワイドバンドギャップ(WBG)半導体:
バンドギャップがおおむね3 eV以上の半導体。バンドギャップは、①半導体デバイスが動作可能な上限温度、②半導体が半導体としての性質を維持できる電界強度(絶縁破壊電界強度)、③半導体が受光、発光する波長、などと密接に関係している。例えば、青色LEDを作製するにはWBG半導体の利用が必須であり、WBG半導体であるGaN(3.4eV)系材料が用いられている。また、パワーデバイス応用においては、絶縁破壊電界強度が大きい材料を使うと、損失が大幅に低減できるため、低損失パワーデバイス実現のためにWBG半導体の研究が活発に進められており、SiC(3.3 eV)やGaNを用いたパワーデバイスが近年実用化されはじめた。 (↑ 本文に戻る)
(注4)高周波デバイス:
マイクロ波やミリ波などの高い周波数の信号を扱う半導体電子デバイスの総称。一般に、周波数を向上させると、それと引き換えに扱える電圧(出力電力)が低下してしまう。特に携帯電話の基地局や通信衛星、レーダーなどでは、高周波と高出力の両立が求められる。既存のSiやGaAsなどでの半導体では限界があり、現在、高周波高出力のデバイスはWBG半導体のGaN系材料の独壇場となりつつある。その先の展開としてUWBG半導体のAlN系材料に大きな期待が寄せられている。(↑ 本文に戻る)
(注5)パワーデバイス:
電力変換装置(パワーエレクトロニクス機器)の主要部品。整流やスイッチングなどの動作をする半導体電子デバイスの総称。パワーデバイスの低損失化が電力変換の損失低減、省エネ実現につながる。この数年間で、SiCパワーデバイスが鉄道や電気自動車で利用され始め、GaNパワーデバイスが、パソコンの充電器などで利用され始めており省エネに大きく貢献している。さらなる省エネ化を実現できるUWBG半導体に大きな期待が寄せられている。(↑ 本文に戻る)
(注6)分布型分極ドーピング(distributed polarization doping):
GaNやAlNなどのIII族窒化物半導体結晶はその強いイオン結合性に起因した大きな分極を有している。分極電荷は通常は結晶の表面と裏面に現れるが、GaNとAlNをx: (1-x)の比で混ぜ合わせた混晶半導体(AlxGa1-xN)においては、組成xが変化すると、GaNとAlNの分極差のために、組成変化に対応した正や負の分極電荷が結晶内部に生じる。この電荷に引き寄せられて電子や正孔が集まってくるため、実質的に不純物ドーピングをしたことと同様の効果が期待できる。これを分布型分極ドーピングと呼ぶ。熱によるドナーからの電子放出(あるいはアクセプタへの電子励起)を必要としないため、室温や低温でも十分な伝導度を示すという利点がある。ただし、組成変化層を高品質で作製することが必要で、高度な薄膜結晶成長技術が求められる。(↑ 本文に戻る)
(注7)IEDM (https://www.ieee-iedm.org/):
米国電気学会(IEEE)が主催する半導体デバイスに関する国際会議。集積回路、イメージセンサー、高周波デバイス、パワーデバイスなど半導体デバイス全体を網羅している。新規性や独創性に優れた論文しか採択されず、半導体デバイス分野のトップクラスの国際会議である。毎年12月にサンフランシスコで開催される。(↑ 本文に戻る)
(注8)不純物ドーピング:
半導体デバイスはn型半導体とp型半導体を上手く組み合わせることにより成り立っている。n型半導体を作製するためには、電子を提供する不純物(ドナー性不純物)をごく微量、その量を正確に制御して添加(ドーピング)する。一方、p型の場合には、電子を結晶から引き抜いて電子の抜け穴(正孔)を形成する不純物(アクセプタ性不純物)を添加する。SiやGaAs、SiCやGaNなどではこの方法で上手くp型、n型を作製できるが、UWBG半導体ではこの手法の適用が困難となる。例えば、AlN系材料ではドナー不純物やアクセプタ不純物のドーピングは可能だが、常温では、熱エネルギーが不十分なため、ドナーからの電子供与、アクセプタへの電子授与が起こらず、十分なn型、p型伝導度を示さない。(↑ 本文に戻る)
[論文情報]
学会名:69th International Electron Device Meeting (IEDM2023)
論文タイトル:Demonstration of AlN-based Vertical p-n Diodes with Dopant-Free Distributed-Polarization Doping
著者:Takeru Kumabe, Akira Yoshikawa, Maki Kushimoto, Yoshio Honda, Manabu Arai, Jun Suda, Hiroshi Amano
DOI: (Technical digestとしてIEEE digital libraryに掲載後付与予定)
◆名古屋大学 研究成果発信サイトはこちら>>>
◆名古屋大学のプレスリリース(本文)はこちら>>>
研究者連絡先
東海国立大学機構 名古屋大学大学院工学研究科 / 未来材料・システム研究所
教授 須田 淳(すだ じゅん)
E-mail : suda[at]nagoya-u.jp




