《本研究のポイント》
- 量産性に優れたMOVPE法注1) により、窒化アルミニウム(AlN)基板上にコヒーレント成長注2) させたAlN/GaN/AlN 高電子移動度トランジスタ(HEMT)注3) を実現。
- 従来のGaN HEMTと比べ、同等水準の抵抗値を実現しつつ、2倍以上の耐圧性能を達成。
- 従来のGaN HEMTで課題だった電流コラプス注4) を抑え、安定動作を実現。
- Crystal ISの高品質AlN単結晶基板、旭化成と名古屋大学により開発した革新的結晶成長技術、そして名古屋大学 エネルギー変換エレクトロニクス実験施設(C-TEFs)の先端デバイス試作環境の融合により、産学連携でブレークスルーを実現。
【研究概要】
名古屋大学未来材料・システム研究所の須田 淳 教授、天野 浩 教授らと旭化成株式会社の研究グループは、窒化アルミニウム(AlN)基板上にコヒーレント成長させたAlN/GaN/AlN 高電子移動度トランジスタ(HEMT) を実現し、従来のGaN HEMTと比べ2倍以上の耐圧性能、低抵抗化、そして電流コラプスの抑制を実証しました。本成果は、通信・レーダー向け高周波デバイス注5) の飛躍的な性能向上に直結する重要なブレークスルーです。
AlNは、ワイドバンドギャップ半導体注6) として知られるシリコンカーバイド(SiC)や窒化ガリウム(GaN)よりも広い約6 eVのバンドギャップを持つウルトラワイドバンドギャップ半導体注7) であり、高い絶縁破壊電界と優れた熱伝導率を兼ね備えています。また、GaNとの格子定数注8) のずれが小さく、GaN/AlN界面の熱抵抗が小さいため、GaNデバイスとの相性が良く、次世代の高周波・高出力デバイス材料として注目されています。本研究グループはこれまで、20 nmのGaNをAlN上にコヒーレント成長させる革新的な結晶成長条件を見出し、世界で初めて有機金属気相成長(MOVPE)法によりAlN(9 nm)/GaN(12 nm)/AlN HEMTを実現しました。
本研究では、結晶成長条件とデバイスプロセスの改善により、当初高かったデバイスの抵抗を二桁低減し、従来のGaN HEMTと同等水準の抵抗値を実現しました。また、従来構造に比べて2倍以上の耐圧性能をもつことを実証し、AlN/GaN/AlN構造の高いポテンシャルを示しました。加えて、従来のGaN HEMTで課題となっていた電流コラプスを抑制し、安定動作を可能にしました。これにより、信頼性の高い高周波・高出力デバイスの実現に大きく前進しました。本成果は、次世代の通信やレーダーシステムにおける高周波・高出力デバイスの性能向上に大きく貢献することが期待されます。
本研究成果は、本学未来材料・システム研究所 旭化成次世代デバイス産学協同研究部門の李 太起(リ テギ)特任助教により2025年12月8日に世界トップクラスの半導体デバイスに関する国際会議(International Electron Device Meeting, IEDM注9) , 米国サンフランシスコ開催)で発表されました。
【研究背景と内容】
次世代の通信システムやレーダー装置では、より高い周波数で大きな電力を扱える半導体デバイスが求められています。このような用途では、広く利用されているシリコン(Si)やガリウムヒ素(GaAs)に比べ、高出力化に対応できる窒化ガリウム(GaN)を用いた高電子移動度トランジスタ(HEMT)の実用化が進んでいます。しかし、従来のAlGaN/GaN HEMTでは、耐圧や放熱性の制約、動作時の電流不安定性(電流コラプス)といった課題がありました。
これらを解決する鍵となるのが、ウルトラワイドバンドギャップ半導体である窒化アルミニウム(AlN)です。AlNは約6 eVの広いバンドギャップ、高い絶縁破壊電界、優れた熱伝導率を持ち、GaNとの格子整合性も良好です(図1)。本研究ではAlN単結晶基板上にコヒーレント成長させたAlN/GaN/AlN HEMTの可能性を実証し、次世代高周波・高出力デバイスへの新しい設計指針を提示します。
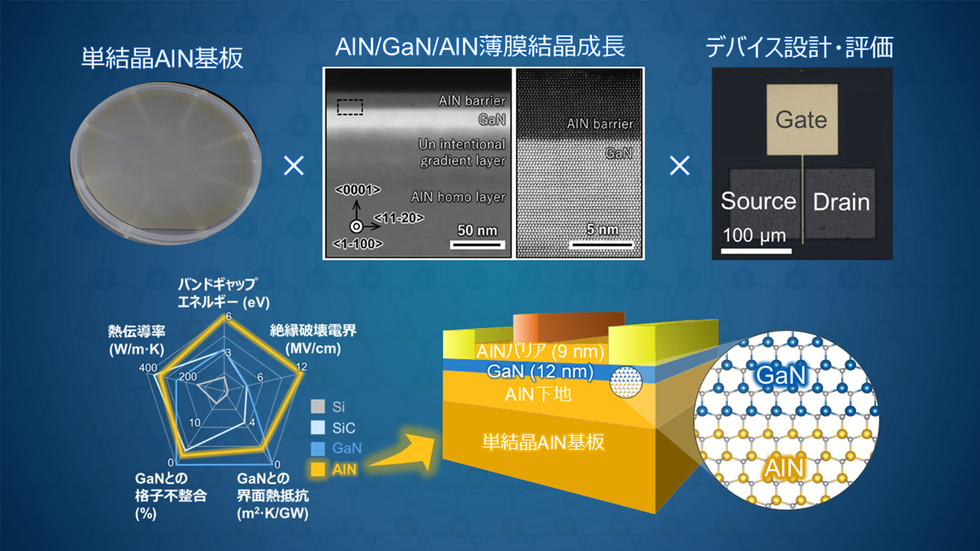
図1:(左)Si、SiC、GaN、AlNの材料特性比較。(右)単結晶AlN基板上にコヒーレント成長させたAlN/GaN/AlN HEMTの模式図。
【研究成果】
本研究では、GaN成長時のGa原料を変えることで結晶中の炭素不純物を大幅に低減し、シート抵抗を2000 Ω/sqから507 Ω/sqへ約4分の1に低減しました。さらに、AlNバリア層のエッチング工程を導入することで、コンタクト抵抗を64 Ωmmから2.4 Ωmmへ約25分の1に低減しました。これにより、デバイスの特性オン抵抗は2桁低減し、従来のAlGaN/GaN HEMTと同等水準に到達しました(図2 (a))。また、耐圧性能の指標である絶縁破壊電界は最大2 MV/cmを記録し、従来のAlGaN/GaN HEMTの値(1 MV/cm以下)の2倍以上を達成しました(図2 (b))。

図2: (a)絶縁破壊電圧とデバイスの特性オン抵抗の関係。 (b)ゲートドレイン間距離と絶縁破壊電圧の関係。
表面保護膜の導入により電流コラプスが完全に抑制され、表面欠陥の影響が低減されていることが確認されました(図3)。電流コラプスは結晶内部の欠陥にも起因するため、この結果はAlN基板上のAlN/GaN/AlN構造が極めて高い結晶品質を有することを示しています。これらの成果は、高周波デバイスの高性能化に向けた重要なブレークスルーです。
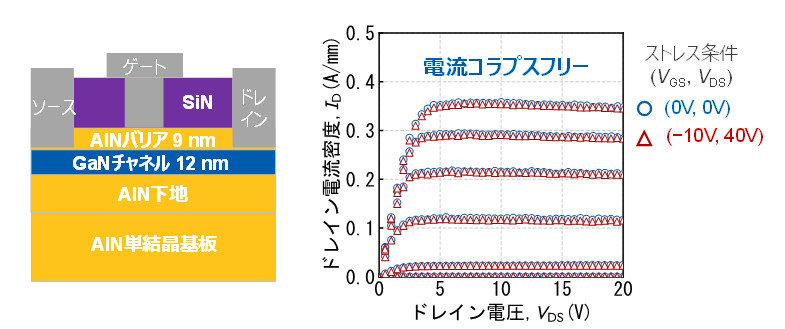
図3:電流コラプスを評価するために行ったパルスI-V測定の結果。パルス幅10μs, パルス周期1 msの条件で測定。ノンストレス条件(0V, 0V)とストレス印加条件(-10V. 40V)の結果が一致していることから、電流コラプスを完全に抑制できていることが分かる。
【成果の意義】
本研究では、AlN/GaN/AlN HEMTの最重要課題であった低抵抗化に成功し、実用化に向けた大きな一歩を踏み出しました。これにより、従来のAlGaN/GaN HEMTを超える高性能化が現実味を帯び、次世代通信やレーダー技術の革新に直結する成果となりました。また、耐圧と電流コラプスの両面で、従来構造の特性を凌駕する結果が得られたのは、高周波・高出力デバイスの性能向上に直結する極めて重要な成果です。これにより、6G通信や衛星通信・高性能レーダーなどの先端技術の実現を大きく前進します。
さらに、今回の成果は「世界で初めてMOVPE法で実証できた」という点で非常に大きな意味を持ちます。青色LEDが量産性に優れたMOVPE法で実現したことで世界に普及したように、AlN/GaN/AlN HEMTもMOVPEでの実証により、広く産業界に普及する可能性が開かれました。
本研究は、ウルトラワイドバンドギャップ半導体を活用した次世代高周波デバイスの量産化に向けた重要な一歩であり、通信・レーダー分野の応用に革新をもたらすことが期待されます。
【本成果をなぜ実現できたか】
今回の成果は、名古屋大学と旭化成の産学連携による総合力の結晶です。高品質なAlN単結晶基板、AlN/GaN/AlN薄膜の成長を可能にする結晶成長技術、HEMTデバイスの設計・プロセス技術、そして精密な評価技術を統合することで、AlN/GaN/AlN HEMTの実証に成功しました。この背景には、両者が長年にわたり積み重ねてきたAlN系半導体研究の知見と、名古屋大学が保有する次世代半導体クリーンルームや先端評価設備(図4)、旭化成の材料開発力(図5)があります。こうした産学連携の強みが、次世代高周波デバイスの実現に向けた大きな一歩を可能にしました。

図4:名古屋大学未来材料・システム研究所のエネルギー変換エレクトロニクス実験施設(C-TEFs)。本施設は、GaN研究における結晶成長・デバイスプロセス・評価を同一スペースで行える約1,000 m2の大空間クリーンルームを有しており、名古屋大学と企業・研究機関の連携を強化する場となっている。
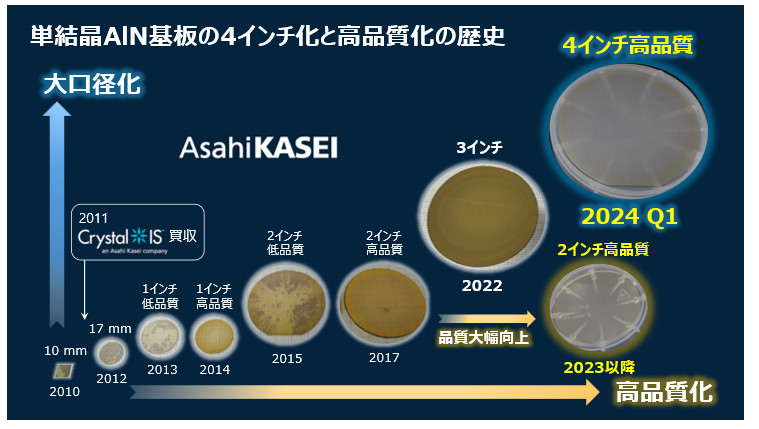
図5:旭化成とCrystal ISによる単結晶AlN基板開発の歴史。
【用語説明】
注1) MOVPE(Metalorganic vapor phase epitaxy;有機金属気相成長) 法
半導体結晶を成長させる代表的な方法の一つ。金属有機化合物とアンモニアなどのガスを高温で反応させ、基板上に薄膜を形成する。大量生産に適しており、LEDやパワーデバイスの製造に広く使われている。 (↑ 本文に戻る)
注2) コヒーレント成長
異なる材料を積層する際に、面内方向の格子定数が一致した状態で成長していることを指す。具体的には、下地層と成長層の格子定数にわずかな差があっても、成長初期では成長層が下地層の結晶格子に合わせて歪み、転位などの欠陥が形成されずに成長する状態である。ただし、成長層の厚みが増すと歪みエネルギーが蓄積し、臨界厚を超えるとコヒーレント成長は維持できなくなる。このため、コヒーレント成長は「歪みを保持したまま格子整合を維持する成長モード」と理解される。 (↑ 本文に戻る)
注3) 高電子移動度トランジスタ(HEMT)
異なる半導体材料を組み合わせて界面に二次元電子ガス(2DEG)を形成し、電子が高速に移動できるようにしたトランジスタ。この構造に窒化ガリウム(GaN)を用いたGaN HEMTは、GaNのワイドバンドギャップ特性により高耐圧・高出力・高温動作が可能である。さらにGaN HEMTでは、AlGaNやAlNなどのバリア層との間で自然に発生する分極効果によって電子が集まり、2DEGが形成されるため、不純物ドーピングが不要である。AlGaNバリアのAl組成が高いほど分極効果が強くなるため、AlNバリアでは分極効果が最大となり高密度の2DEGが形成される。 (↑ 本文に戻る)
注4) 電流コラプス
HEMTなどの高周波・高電圧デバイスで、オフ状態からオン状態に切り替えた際に、本来は流れるはずの電流が一時的に大きく減少する現象。この現象はスイッチング動作における性能低下の主な要因であり、出力電力や効率に悪影響を与える。特にGaN系HEMTでは、表面欠陥や界面欠陥、結晶内部の欠陥に電荷がトラップされることが原因となる。この問題を抑えるためには、表面保護膜の開発やデバイスプロセス改善、結晶品質の向上が重要である。 (↑ 本文に戻る)
注5) 高周波デバイス
マイクロ波やミリ波などの高い周波数の信号を扱う半導体電子デバイスの総称。一般に、周波数を高くすると扱える電圧(出力電力)が低下するため、通信やレーダー用途では高周波と高出力の両立が重要な課題となる。従来のSiやGaAsでは性能に限界があり、現在ではワイドバンドギャップ半導体であるGaN系材料が高周波・高出力デバイスの主流になっている。さらにその先の展開として、ウルトラワイドバンドギャップ半導体であるAlN系材料への期待が高まっている。 (↑ 本文に戻る)
注6) ワイドバンドギャップ半導体
バンドギャップとは、電子が価電子帯から伝導帯へ移動するために必要なエネルギーのことで、この値が大きいほど材料は高電圧や高温に耐えやすくなる。ワイドバンドギャップ半導体は、従来の半導体材料であるSi(1.1 eV)やGaAs(1.4 eV)よりもバンドギャップが広い半導体を指す。代表的な材料には、SiC(3.3 eV)やGaN(3.4 eV)があり、一般に3 eV程度のバンドギャップを持つ。これらの材料は、高電圧・高周波・高効率が求められる分野で不可欠である。 (↑ 本文に戻る)
注7) ウルトラワイドバンドギャップ半導体
おおむね4eV以上のバンドギャップを持つ材料。代表例としては、AlN(6.0 eV)、ダイヤモンド(5.5 eV)、Ga2O3(4.8 eV)などがある。原理的にはワイドバンドギャップ半導体よりも高電圧・高周波・高効率が求められる分野で高い性能をもつことが期待できる。 (↑ 本文に戻る)
注8) 格子定数
結晶の基本単位格子の辺の長さ。結晶構造を決定する重要なパラメータ。AlNとGaNのa軸の格子定数はそれぞれ3.11Å、3.19Åであり、格子不整合度は2.4%である。このわずかな違いでも、AlN上にGaNをコヒーレント成長させるのは難しいとされている。しかし当研究グループでは、独自技術によりこの課題を克服し、コヒーレント成長を実現した。一方で、Si、サファイヤ、SiC基板とGaNとの格子不整合度はそれぞれ17%、16%、3.8%とさらに大きく、GaNを成長させると多くの欠陥が入ることが知られている。その結果、デバイス性能や信頼性が低下する原因になる。 (↑ 本文に戻る)
注9) IEDM(https://www.ieee-iedm.org)
米国電気学会(IEEE)が主催する半導体デバイス分野で世界最高峰の国際会議。集積回路、イメージセンサー、高周波デバイス、パワーデバイスなど、半導体デバイス技術の最先端を網羅されており、世界中の企業・大学・研究機関が注目している。毎年12月に米国サンフランシスコで開催され、半導体業界の未来を方向づける場として位置づけられている。 (↑ 本文に戻る)
【論文情報】
雑誌名:71st International Electron Device Meeting (IEDM) 2025
論文タイトル:Low-Resistance and Current-Collapse-Free MOVPE-Grown Pseudomorphic AlN/GaN/AlN HEMTs on AlN substrates
著者:TaeGi Lee1,2, Akira Yoshikawa1,2, Yoshihito Hagihara2, Sho Sugiyama1,2, Manabu Arai1, Yuji Ando1, Jun Suda1, Hiroshi Amano1
1名古屋大学 未来材料・システム研究所(IMaSS)
2旭化成株式会社 研究・開発本部 先端技術研究所 次世代化合物半導体開発部
DOI:(Technical digestとしてIEEE digital libraryに掲載後付与予定)
研究者連絡先
名古屋大学大学院工学研究科 / 未来材料・システム研究所(IMaSS)
教授 須田 淳
E-mail: suda.jun.t8[at]f.mail.nagoya-u.ac.jp ※メール送信の際は[at]を@に置き換えてください。